※1.证明费米能级是常数
E=qdxdEi
Dp=qtktμp
Jp=jp(漂)+jp(扩)=qμpPE−qDpdxdp=0
P=niektEi−EF,对x求导后代入原式:Jp=μppdxdEF=0∴dxdEF=0,同理Jn
※2. 耗尽区宽度W与内建电势的关系Vbi
dx2d2ϕ=+ϵsqNA,−xp≤x<0
dx2d2ϕ=−ϵsqND,0<x≤xn
E(x)=−dxdϕ=−ϵsqNAX+C1
E(xp)=E(xn)=0
E(x)=−ϵsqNA(x+xp)
NAxp=NDxn
Em=ϵsqNAxp
Vbi=−∫xpxnE(x)dx=21EmW
W=q2ϕsNANDNA+NDVbi
※3. 正反偏电压能带图


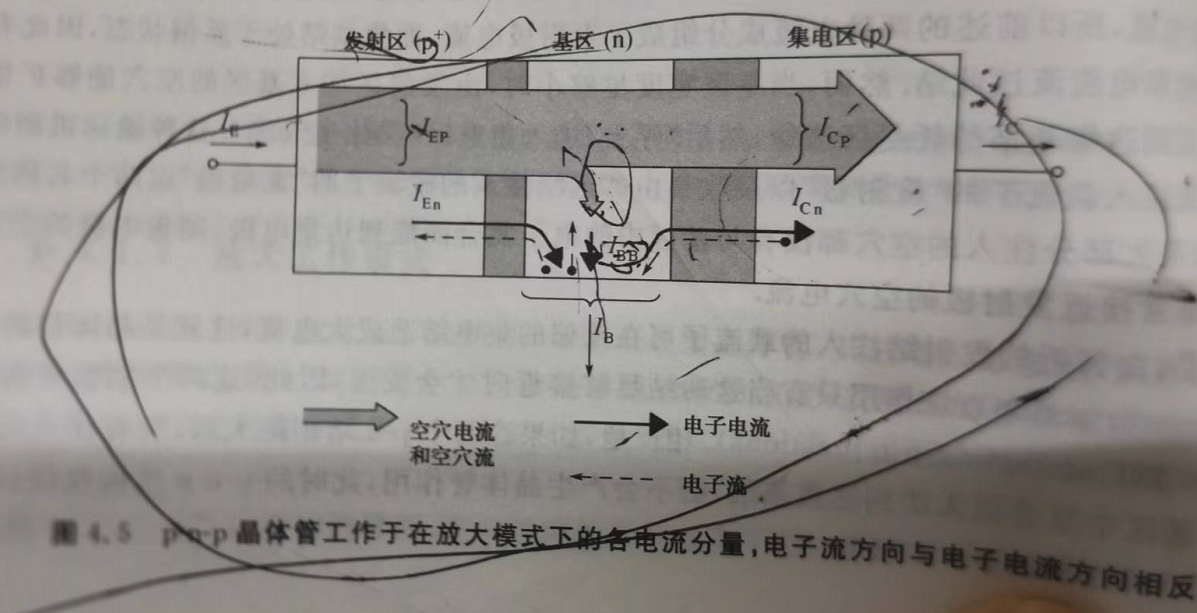
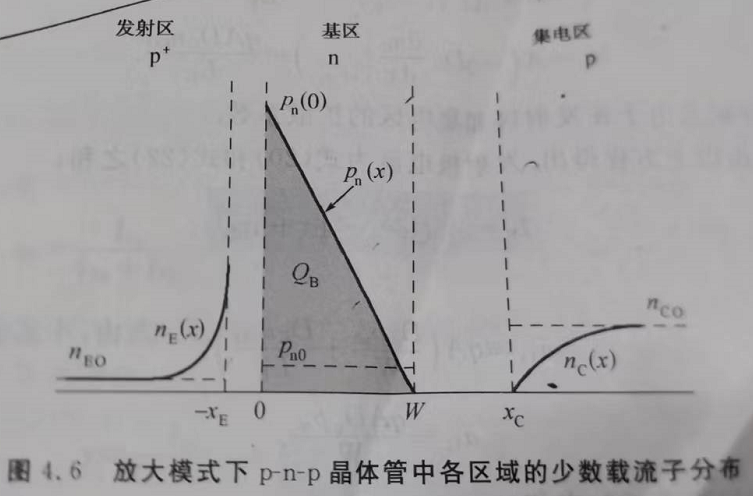
※4.
内建电势Vbi=qktlnni2NAND
耗尽区的宽度W=q2ϕsNANDNA+ND(Vbi−Va)
最大电场Em=W2Vbi
电势ϕ(x)=WVbi−Va(2−Wx)x
※ 6. 少数载流子浓度

8.
势垒高度:

内建电势:
耗尽层宽度:
最大电场:
※ 9. 最小外延层厚度
VN=qktlnNDNC
Vbi=ϕbn−Vn
W=qND2ϕsVBi
※ 关断电流τoff=IR,aveQp−A
所以与正反向电流的比值、少数载流子寿命有关
※肖特基接触和欧姆接触
肖特基接触是指金属和半导体材料相接触的时候,在界面处半导体的能带弯曲,形成肖特基势垒。势垒的存在才导致了大的界面电阻。与之对应的是欧姆接触,界面处势垒非常小或者是没有接触势垒。
10. 中性基区宽度W,忽略发射极和集电极延迟
τT=τB+τE+τC=2DPW2
fT=2πτT1
※13. 阈值电压公式

∴VT=C0qNAWm+ϕs(inv)≈C02ϕsqNA(2ϕB)+2ϕB
※15. 表面耗尽区静电势

※16. 改善频率响应的三个方法
τB=2DPW2
- 缩短穿越基区时间,所以设计为窄基区宽度
- 采用npn,因为电子的扩散系数是空穴的3倍
- 利用有内建电场的缓变掺杂基区,有助于载流子向集电极移动